乾式蝕刻設備常見溫控痛點
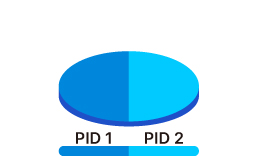 複雜的製程配方與溫度控制
複雜的製程配方與溫度控制
 氣體、電漿導入的溫度干擾
氣體、電漿導入的溫度干擾
 晶圓加熱延遲
晶圓加熱延遲
乾式蝕刻製程中,溫度控制是相當重要的因素。透過靜電吸盤 (E-Chuck, ESC) 加熱器將晶圓升溫到一定溫度,使其有效率地進行均勻的蝕刻反應。
乾式蝕刻製程中會分階段導入不同的氣體,使電漿與晶圓薄膜進行均勻的蝕刻反應。然而,複雜的製程配方與導入會影響晶圓溫控的穩定性,進而影響半導體元件的良率品質。
乾式蝕刻的形狀和線寬受到蝕刻反應生成物的側壁沉積所支配,而反應生成物的附著性則強烈被溫度所影響著。隨著氣體導入與電漿蝕刻的進行,晶圓溫度也會同步被氣體降溫並被電漿加熱,為了提高蝕刻與側壁沉積的精度,除了精準控制靜電吸盤對晶圓的加熱,還需要考量氣體和電漿所造成的額外失溫和升溫。
此外,在加熱的過程中,因為晶圓厚度與溫升延遲的特性,加熱器會朝目標溫度 (SV) 持續輸出加熱,容易造成晶圓加熱過度而影響元件品質。